| Name: | AFM NT-MDT SMENA - (AFM) | | Category: | Morphological, compositional and structural characterization | | 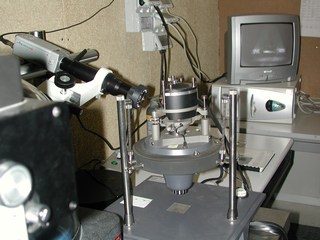 | | General description | Atomic Force Microscope (NT-MDT, contact, semi-contact, lateral force and other modes of measure), scanning area 100x100 µm2).
Atomic force microscopy (AFM) or scanning force microscopy (SFM) is a very high-resolution type of scanning probe microscopy, with demonstrated resolution on the order of fractions of a nanometer, more than 1000 times better than the optical diffraction limit.
The AFM consists of a cantilever with a sharp tip (probe) at its end that is used to scan the specimen surface. The cantilever is typically silicon or silicon nitride with a tip radius of curvature on the order of nanometers. When the tip is brought into proximity of a sample surface, forces between the tip and the sample lead to a deflection of the cantilever according to Hooke's law. Depending on the situation, forces that are measured in AFM include mechanical contact force, van der Waals forces, capillary forces, chemical bonding, electrostatic forces, magnetic forces | | A cosa serve: | Il microscopio a forza atomica permette di effettuare analisi non distruttive di superfici, con una risoluzione nanometrica.
La microscopia a forza atomica è in grado di fornire informazioni su rugosità, dimensioni e distribuzione dei grani, presenza di difetti superficiali, presenza di inclusioni, cluster o seconde fasi. La tecnica permette inoltre di misurare lo spessore di film sottili o coatings, anche otticamente trasparenti.
Utilizzando opportune sonde è possibile effettuare mappature superficiali a scala micro e nanometrica delle proprietà elettriche e magnetiche della superficie. | | Come funziona: | Il principio di funzionamento della microscopia a forza atomica sfrutta le interazioni che si vengono a formare fra gli atomi della punta dello strumento e quelli della superficie da analizzare.
La punta, le cui dimensioni sono dell'ordine della decina di nanometri, esplora la superficie del campione, a contatto o a brevissima distanza da essa (circa 10 Angstrom,
lo strumento di norma lavora nella regione delle forze attrattive di Van der Waals).
Le interazioni fra punta e campione provocano deflessioni della leva (cantilever) su cui è montata la sonda che vengono a loro volta rilevate, attraverso un sistema ottico costituito da un laser e un fotodiodo, dal software e tradotte in un'immagine topografica della superficie del campione. | | Per cosa si usa: | Si usa per lo studio della morfologia superficiale di superfici planari costituite da solidi, sia conduttivi che isolanti, con rugosità superficiale inferiore ai 5 micron. |
|
|
|